
來源:內容由半導體行業觀察(ID:icbank)轉自半導體材料與工藝設備,謝謝。
由於MOSFET的結構,通常它可以做到電流很大,可以到上KA,但耐壓能力沒有IGBT強。
IGBT可以做很大功率,電流和電壓都可以,就是一點頻率不是太高,目前IGBT硬开關速度可以到100KHZ,那已經是不錯了。不過相對於MOSFET的工作頻率還是九牛一毛,MOSFET可以工作到幾百KHZ,上MHZ,以至幾十MHZ。
66就其應用:根據其特點MOSFET應用於开關電源,鎮流器,高頻感應加熱;高頻逆變焊機;通信電源等等高頻電源領域;IGBT集中應用於焊機,逆變器,變頻器,電鍍電解電源,超音頻感應加熱等領域。
开關電源(SMPS) 的性能在很大程度上依賴於功率半導體器件的選擇,即开關管和整流器。 雖然沒有萬全的方案來解決選擇IGBT還是MOSFET的問題,但針對特定SMPS應用中的IGBT 和 MOSFET進行性能比較,確定關鍵參數的範圍還是能起到一定的參考作用。 本文將對一些參數進行探討,如硬开關和軟开關ZVS(零電壓轉換) 拓撲中的开關損耗,並對電路和器件特性相關的三個主要功率开關損耗—導通損耗、傳導損耗和關斷損耗進行描述。此外,還通過舉例說明二極管的恢復特性是決定MOSFET 或 IGBT導通开關損耗的主要因素,討論二極管恢復性能對於硬开關拓撲的影響。 66 66導通損耗
除了IGBT的電壓下降時間較長外,IGBT和功率MOSFET的導通特性十分類似。由基本的IGBT等效電路(見圖1)可看出,完全調節PNP BJT集電極基極區的少數載流子所需的時間導致了導通電壓拖尾出現。 這種延遲引起了類飽和效應,使集電極/發射極電壓不能立即下降到其VCE(sat)值。這種效應也導致了在ZVS情況下,在負載電流從組合封裝的反向並聯二極管轉換到IGBT的集電極的瞬間,VCE電壓會上升。IGBT產品規格書中列出的Eon能耗是每一轉換周期Icollector與VCE乘積的時間積分,單位爲焦耳,包含了與類飽和相關的其他損耗。其又分爲兩個Eon能量參數,Eon1和Eon2。Eon1是沒有包括與硬开關二極管恢復損耗相關能耗的功率損耗;Eon2則包括了與二極管恢復相關的硬开關導通能耗,可通過恢復與IGBT組合封裝的二極管相同的二極管來測量,典型的Eon2測試電路如圖2所示。IGBT通過兩個脈衝進行开關轉換來測量Eon。第一個脈衝將增大電感電流以達致所需的測試電流,然後第二個脈衝會測量測試電流在二極管上恢復的Eon損耗。
這種延遲引起了類飽和效應,使集電極/發射極電壓不能立即下降到其VCE(sat)值。這種效應也導致了在ZVS情況下,在負載電流從組合封裝的反向並聯二極管轉換到IGBT的集電極的瞬間,VCE電壓會上升。IGBT產品規格書中列出的Eon能耗是每一轉換周期Icollector與VCE乘積的時間積分,單位爲焦耳,包含了與類飽和相關的其他損耗。其又分爲兩個Eon能量參數,Eon1和Eon2。Eon1是沒有包括與硬开關二極管恢復損耗相關能耗的功率損耗;Eon2則包括了與二極管恢復相關的硬开關導通能耗,可通過恢復與IGBT組合封裝的二極管相同的二極管來測量,典型的Eon2測試電路如圖2所示。IGBT通過兩個脈衝進行开關轉換來測量Eon。第一個脈衝將增大電感電流以達致所需的測試電流,然後第二個脈衝會測量測試電流在二極管上恢復的Eon損耗。 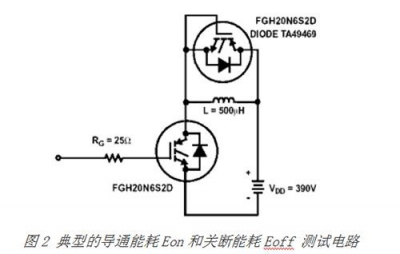 在硬开關導通的情況下,柵極驅動電壓和阻抗以及整流二極管的恢復特性決定了Eon开關損耗。對於像傳統CCM升壓PFC電路來說,升壓二極管恢復特性在Eon (導通) 能耗的控制中極爲重要。除了選擇具有最小Trr和QRR的升壓二極管之外,確保該二極管擁有軟恢復特性也非常重要。軟化度,即tb/ta比率,對开關器件產生的電氣噪聲和電壓尖脈衝有相當的影響。某些高速二極管在時間tb內,從IRM(REC)开始的電流下降速率(di/dt)很高,故會在電路寄生電感中產生高電壓尖脈衝。這些電壓尖脈衝會引起電磁幹擾(EMI),並可能在二極管上導致過高的反向電壓。 在硬开關電路中,如全橋和半橋拓撲中,與IGBT組合封裝的是快恢復管或MOSFET體二極管,當對應的开關管導通時二極管有電流經過,因而二極管的恢復特性決定了Eon損耗。所以,選擇具有快速體二極管恢復特性的MOSFET十分重要。不幸的是,MOSFET的寄生二極管或體二極管的恢復特性比業界目前使用的分立二極管要緩慢。因此,對於硬开關MOSFET應用而言,體二極管常常是決定SMPS工作頻率的限制因素。 一般來說,IGBT組合封裝二極管的選擇要與其應用匹配,具有較低正向傳導損耗的較慢型超快二極管與較慢的低VCE(sat)電機驅動IGBT組合封裝在一起。相反地,軟恢復超快二極管,可與高頻SMPS2开關模式IGBT組合封裝在一起。 除了選擇正確的二極管外,設計人員還能夠通過調節柵極驅動導通源阻抗來控制Eon損耗。降低驅動源阻抗將提高IGBT或MOSFET的導通di/dt及減小Eon損耗。Eon損耗和EMI需要折中,因爲較高的di/dt會導致電壓尖脈衝、輻射和傳導EMI增加。爲選擇正確的柵極驅動阻抗以滿足導通di/dt 的需求,可能需要進行電路內部測試與驗證,然後根據MOSFET轉換曲线可以確定大概的值 (見圖3)。
在硬开關導通的情況下,柵極驅動電壓和阻抗以及整流二極管的恢復特性決定了Eon开關損耗。對於像傳統CCM升壓PFC電路來說,升壓二極管恢復特性在Eon (導通) 能耗的控制中極爲重要。除了選擇具有最小Trr和QRR的升壓二極管之外,確保該二極管擁有軟恢復特性也非常重要。軟化度,即tb/ta比率,對开關器件產生的電氣噪聲和電壓尖脈衝有相當的影響。某些高速二極管在時間tb內,從IRM(REC)开始的電流下降速率(di/dt)很高,故會在電路寄生電感中產生高電壓尖脈衝。這些電壓尖脈衝會引起電磁幹擾(EMI),並可能在二極管上導致過高的反向電壓。 在硬开關電路中,如全橋和半橋拓撲中,與IGBT組合封裝的是快恢復管或MOSFET體二極管,當對應的开關管導通時二極管有電流經過,因而二極管的恢復特性決定了Eon損耗。所以,選擇具有快速體二極管恢復特性的MOSFET十分重要。不幸的是,MOSFET的寄生二極管或體二極管的恢復特性比業界目前使用的分立二極管要緩慢。因此,對於硬开關MOSFET應用而言,體二極管常常是決定SMPS工作頻率的限制因素。 一般來說,IGBT組合封裝二極管的選擇要與其應用匹配,具有較低正向傳導損耗的較慢型超快二極管與較慢的低VCE(sat)電機驅動IGBT組合封裝在一起。相反地,軟恢復超快二極管,可與高頻SMPS2开關模式IGBT組合封裝在一起。 除了選擇正確的二極管外,設計人員還能夠通過調節柵極驅動導通源阻抗來控制Eon損耗。降低驅動源阻抗將提高IGBT或MOSFET的導通di/dt及減小Eon損耗。Eon損耗和EMI需要折中,因爲較高的di/dt會導致電壓尖脈衝、輻射和傳導EMI增加。爲選擇正確的柵極驅動阻抗以滿足導通di/dt 的需求,可能需要進行電路內部測試與驗證,然後根據MOSFET轉換曲线可以確定大概的值 (見圖3)。 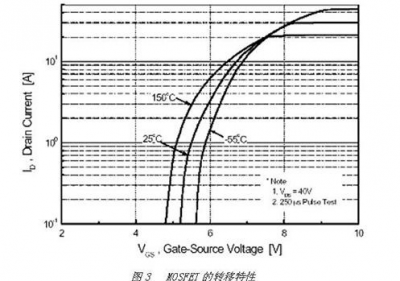
假定在導通時,FET電流上升到10A,根據圖3中25℃的那條曲线,爲了達到10A的值,柵極電壓必須從5.2V轉換到6.7V,平均GFS爲10A/(6.7V-5.2V)=6.7m。  公式1 獲得所需導通di/dt的柵極驅動阻抗 把平均GFS值運用到公式1中,得到柵極驅動電壓Vdrive=10V,所需的 di/dt=600A/s,FCP11N60典型值VGS(avg)=6V,Ciss=1200pF;於是可以計算出導通柵極驅動阻抗爲37。由於在圖3的曲线中瞬態GFS值是一條斜线,會在Eon期間出現變化,意味着di/dt也會變化。呈指數衰減的柵極驅動電流Vdrive和下降的Ciss作爲VGS的函數也進入了該公式,表現具有令人驚訝的线性電流上升的總體效應。 同樣的,IGBT也可以進行類似的柵極驅動導通阻抗計算,VGE(avg) 和GFS可以通過IGBT的轉換特性曲线來確定,並應用VGE(avg)下的CIES值代替Ciss。計算所得的IGBT導通柵極驅動阻抗爲100,該值比前面的37高,表明IGBT GFS較高,而CIES較低。這裏的關鍵之處在於,爲了從MOSFET轉換到IGBT,必須對柵極驅動電路進行調節。
公式1 獲得所需導通di/dt的柵極驅動阻抗 把平均GFS值運用到公式1中,得到柵極驅動電壓Vdrive=10V,所需的 di/dt=600A/s,FCP11N60典型值VGS(avg)=6V,Ciss=1200pF;於是可以計算出導通柵極驅動阻抗爲37。由於在圖3的曲线中瞬態GFS值是一條斜线,會在Eon期間出現變化,意味着di/dt也會變化。呈指數衰減的柵極驅動電流Vdrive和下降的Ciss作爲VGS的函數也進入了該公式,表現具有令人驚訝的线性電流上升的總體效應。 同樣的,IGBT也可以進行類似的柵極驅動導通阻抗計算,VGE(avg) 和GFS可以通過IGBT的轉換特性曲线來確定,並應用VGE(avg)下的CIES值代替Ciss。計算所得的IGBT導通柵極驅動阻抗爲100,該值比前面的37高,表明IGBT GFS較高,而CIES較低。這裏的關鍵之處在於,爲了從MOSFET轉換到IGBT,必須對柵極驅動電路進行調節。
66 66
傳導損耗需謹慎
在比較額定值爲600V的器件時,IGBT的傳導損耗一般比相同芯片大小的600 V MOSFET少。這種比較應該是在集電極和漏極電流密度可明顯感測,並在指明最差情況下的工作結溫下進行的。例如,FGP20N6S2 SMPS2 IGBT 和 FCP11N60 SuperFET均具有1℃/W的RJC值。圖4顯示了在125℃的結溫下傳導損耗與直流電流的關系,圖中曲线表明在直流電流大於2.92A後,MOSFET的傳導損耗更大。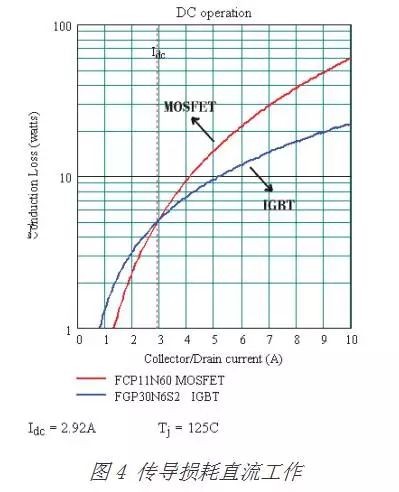
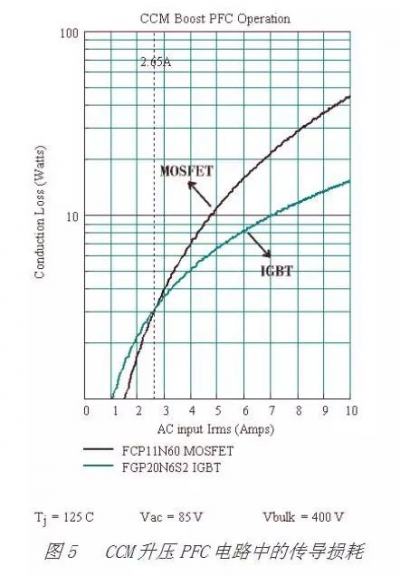 不過,圖4中的直流傳導損耗比較不適用於大部分應用。同時,圖5中顯示了傳導損耗在CCM (連續電流模式)、升壓PFC電路,125℃的結溫以及85V的交流輸入電壓Vac和400 Vdc直流輸出電壓的工作模式下的比較曲线。圖中,MOSFET-IGBT的曲线相交點爲2.65A RMS。對PFC電路而言,當交流輸入電流大於2.65A RMS時,MOSFET具有較大的傳導損耗。2.65A PFC交流輸入電流等於MOSFET中由公式2計算所得的2.29A RMS。MOSFET傳導損耗、I2R,利用公式2定義的電流和MOSFET 125℃的RDS(on)可以計算得出。把RDS(on)隨漏極電流變化的因素考慮在內,該傳導損耗還可以進一步精確化,這種關系如圖6所示。
不過,圖4中的直流傳導損耗比較不適用於大部分應用。同時,圖5中顯示了傳導損耗在CCM (連續電流模式)、升壓PFC電路,125℃的結溫以及85V的交流輸入電壓Vac和400 Vdc直流輸出電壓的工作模式下的比較曲线。圖中,MOSFET-IGBT的曲线相交點爲2.65A RMS。對PFC電路而言,當交流輸入電流大於2.65A RMS時,MOSFET具有較大的傳導損耗。2.65A PFC交流輸入電流等於MOSFET中由公式2計算所得的2.29A RMS。MOSFET傳導損耗、I2R,利用公式2定義的電流和MOSFET 125℃的RDS(on)可以計算得出。把RDS(on)隨漏極電流變化的因素考慮在內,該傳導損耗還可以進一步精確化,這種關系如圖6所示。 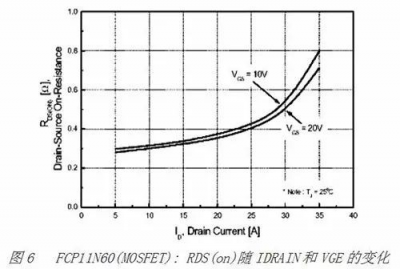 一篇名爲“如何將功率MOSFET的RDS(on)對漏極電流瞬態值的依賴性包含到高頻三相PWM逆變器的傳導損耗計算中”的IEEE文章描述了如何確定漏極電流對傳導損耗的影響。作爲ID之函數,RDS(on)變化對大多數SMPS拓撲的影響很小。例如,在PFC電路中,當FCP11N60 MOSFET的峰值電流ID爲11A——兩倍於5.5A (規格書中RDS(on) 的測試條件) 時,RDS(on)的有效值和傳導損耗會增加5%。 在MOSFET傳導極小佔空比的高脈衝電流拓撲結構中,應該考慮圖6所示的特性。如果FCP11N60 MOSFET工作在一個電路中,其漏極電流爲佔空比7.5%的20A脈衝 (即5.5A RMS),則有效的RDS(on)將比5.5A(規格書中的測試電流)時的0.32歐姆大25%。
一篇名爲“如何將功率MOSFET的RDS(on)對漏極電流瞬態值的依賴性包含到高頻三相PWM逆變器的傳導損耗計算中”的IEEE文章描述了如何確定漏極電流對傳導損耗的影響。作爲ID之函數,RDS(on)變化對大多數SMPS拓撲的影響很小。例如,在PFC電路中,當FCP11N60 MOSFET的峰值電流ID爲11A——兩倍於5.5A (規格書中RDS(on) 的測試條件) 時,RDS(on)的有效值和傳導損耗會增加5%。 在MOSFET傳導極小佔空比的高脈衝電流拓撲結構中,應該考慮圖6所示的特性。如果FCP11N60 MOSFET工作在一個電路中,其漏極電流爲佔空比7.5%的20A脈衝 (即5.5A RMS),則有效的RDS(on)將比5.5A(規格書中的測試電流)時的0.32歐姆大25%。  公式2 CCM PFC電路中的RMS電流 式2中,Iacrms是PFC電路RMS輸入電流;Vac是PFC電路RMS輸入電壓;Vout是直流輸出電壓。 在實際應用中,計算IGBT在類似PFC電路中的傳導損耗將更加復雜,因爲每個开關周期都在不同的IC上進行。IGBT的VCE(sat)不能由一個阻抗表示,比較簡單直接的方法是將其表示爲阻抗RFCE串聯一個固定VFCE電壓,VCE(ICE)=ICERFCE VFCE。於是,傳導損耗便可以計算爲平均集電極電流與VFCE的乘積,加上RMS集電極電流的平方,再乘以阻抗RFCE。 圖5中的示例僅考慮了CCM PFC電路的傳導損耗,即假定設計目標在維持最差情況下的傳導損耗小於15W。以FCP11N60 MOSFET爲例,該電路被限制在5.8A,而FGP20N6S2 IGBT可以在9.8A的交流輸入電流下工作。它可以傳導超過MOSFET 70% 的功率。 雖然IGBT的傳導損耗較小,但大多數600V IGBT都是PT (穿透) 型器件。PT器件具有NTC (負溫度系數)特性,不能並聯分流。或許,這些器件可以通過匹配器件VCE(sat)、VGE(TH) (柵射閾值電壓) 及機械封裝以有限的成效進行並聯,以使得IGBT芯片們的溫度可以保持一致的變化。相反地,MOSFET具有PTC (正溫度系數),可以提供良好的電流分流。
公式2 CCM PFC電路中的RMS電流 式2中,Iacrms是PFC電路RMS輸入電流;Vac是PFC電路RMS輸入電壓;Vout是直流輸出電壓。 在實際應用中,計算IGBT在類似PFC電路中的傳導損耗將更加復雜,因爲每個开關周期都在不同的IC上進行。IGBT的VCE(sat)不能由一個阻抗表示,比較簡單直接的方法是將其表示爲阻抗RFCE串聯一個固定VFCE電壓,VCE(ICE)=ICERFCE VFCE。於是,傳導損耗便可以計算爲平均集電極電流與VFCE的乘積,加上RMS集電極電流的平方,再乘以阻抗RFCE。 圖5中的示例僅考慮了CCM PFC電路的傳導損耗,即假定設計目標在維持最差情況下的傳導損耗小於15W。以FCP11N60 MOSFET爲例,該電路被限制在5.8A,而FGP20N6S2 IGBT可以在9.8A的交流輸入電流下工作。它可以傳導超過MOSFET 70% 的功率。 雖然IGBT的傳導損耗較小,但大多數600V IGBT都是PT (穿透) 型器件。PT器件具有NTC (負溫度系數)特性,不能並聯分流。或許,這些器件可以通過匹配器件VCE(sat)、VGE(TH) (柵射閾值電壓) 及機械封裝以有限的成效進行並聯,以使得IGBT芯片們的溫度可以保持一致的變化。相反地,MOSFET具有PTC (正溫度系數),可以提供良好的電流分流。
66 66
關斷損耗 —問題尚未結束
在硬开關、鉗位感性電路中,MOSFET的關斷損耗比IGBT低得多,原因在於IGBT 的拖尾電流,這與清除圖1中PNP BJT的少數載流子有關。圖7顯示了集電極電流ICE和結溫Tj的函數Eoff,其曲线在大多數IGBT數據表中都有提供。這些曲线基於鉗位感性電路且測試電壓相同,並包含拖尾電流能量損耗。 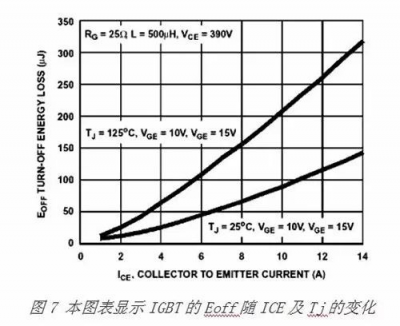 圖2顯示了用於測量IGBT Eoff的典型測試電路, 它的測試電壓,即圖2中的VDD,因不同制造商及個別器件的BVCES而異。在比較器件時應考慮這測試條件中的VDD,因爲在較低的VDD鉗位電壓下進行測試和工作將導致Eoff能耗降低。 降低柵極驅動關斷阻抗對減小IGBT Eoff損耗影響極微。如圖1所示,當等效的多數載流子MOSFET關斷時,在IGBT少數載流子BJT中仍存在存儲時間延遲td(off)I。不過,降低Eoff驅動阻抗將會減少米勒電容CRES和關斷VCE的dv/dt造成的電流注到柵極驅動回路中的風險,避免使器件重新偏置爲傳導狀態,從而導致多個產生Eoff的开關動作。 ZVS和ZCS拓撲在降低MOSFET和IGBT的關斷損耗方面很有優勢。不過ZVS的工作優點在IGBT中沒有那么大,因爲當集電極電壓上升到允許多余存儲電荷進行耗散的電勢值時,會引發拖尾衝擊電流Eoff。ZCS拓撲可以提升最大的IGBT Eoff性能。正確的柵極驅動順序可使IGBT柵極信號在第二個集電極電流過零點以前不被清除,從而顯著降低IGBT ZCS Eoff 。 MOSFET的Eoff能耗是其米勒電容Crss、柵極驅動速度、柵極驅動關斷源阻抗及源極功率電路路徑中寄生電感的函數。該電路寄生電感Lx (如圖8所示) 產生一個電勢,通過限制電流速度下降而增加關斷損耗。在關斷時,電流下降速度di/dt由Lx和VGS(th)決定。如果Lx=5nH,VGS(th)=4V,則最大電流下降速度爲VGS(th)/Lx=800A/s。
圖2顯示了用於測量IGBT Eoff的典型測試電路, 它的測試電壓,即圖2中的VDD,因不同制造商及個別器件的BVCES而異。在比較器件時應考慮這測試條件中的VDD,因爲在較低的VDD鉗位電壓下進行測試和工作將導致Eoff能耗降低。 降低柵極驅動關斷阻抗對減小IGBT Eoff損耗影響極微。如圖1所示,當等效的多數載流子MOSFET關斷時,在IGBT少數載流子BJT中仍存在存儲時間延遲td(off)I。不過,降低Eoff驅動阻抗將會減少米勒電容CRES和關斷VCE的dv/dt造成的電流注到柵極驅動回路中的風險,避免使器件重新偏置爲傳導狀態,從而導致多個產生Eoff的开關動作。 ZVS和ZCS拓撲在降低MOSFET和IGBT的關斷損耗方面很有優勢。不過ZVS的工作優點在IGBT中沒有那么大,因爲當集電極電壓上升到允許多余存儲電荷進行耗散的電勢值時,會引發拖尾衝擊電流Eoff。ZCS拓撲可以提升最大的IGBT Eoff性能。正確的柵極驅動順序可使IGBT柵極信號在第二個集電極電流過零點以前不被清除,從而顯著降低IGBT ZCS Eoff 。 MOSFET的Eoff能耗是其米勒電容Crss、柵極驅動速度、柵極驅動關斷源阻抗及源極功率電路路徑中寄生電感的函數。該電路寄生電感Lx (如圖8所示) 產生一個電勢,通過限制電流速度下降而增加關斷損耗。在關斷時,電流下降速度di/dt由Lx和VGS(th)決定。如果Lx=5nH,VGS(th)=4V,則最大電流下降速度爲VGS(th)/Lx=800A/s。  66 66
66 66
總結
在選用功率开關器件時,並沒有萬全的解決方案,電路拓撲、工作頻率、環境溫度和物理尺寸,所有這些約束都會在做出最佳選擇時起着作用。 在具有最小Eon損耗的ZVS 和 ZCS應用中,MOSFET由於具有較快的开關速度和較少的關斷損耗,因此能夠在較高頻率下工作。 對硬开關應用而言,MOSFET寄生二極管的恢復特性可能是個缺點。相反,由於IGBT組合封裝內的二極管與特定應用匹配,極佳的軟恢復二極管可與更高速的SMPS器件相配合。66 66
後語
MOSFE和IGBT是沒有本質區別的,人們常問的“是MOSFET好還是IGBT好”這個問題本身就是錯誤的。至於我們爲何有時用MOSFET,有時又不用MOSFET而採用IGBT,不能簡單的用好和壞來區分,來判定,需要用辯證的方法來考慮這個問題。
*免責聲明:本文由作者原創。文章內容系作者個人觀點,半導體行業觀察轉載僅爲了傳達一種不同的觀點,不代表半導體行業觀察對該觀點贊同或支持,如果有任何異議,歡迎聯系半導體行業觀察。
今天是《半導體行業觀察》爲您分享的第3359內容,歡迎關注。
推薦閱讀
金剛石半導體,越來越近
Jim Keller究竟在做什么芯片?
戈登摩爾留給我們的“遺產”
半導體行業觀察
66『半導體第一垂直媒體』
實時 專業 原創 深度
識別二維碼,回復下方關鍵詞,閱讀更多
晶圓|集成電路|設備|汽車芯片|存儲|台積電|AI|封裝
回復 投稿,看《如何成爲“半導體行業觀察”的一員 》
回復 搜索,還能輕松找到其他你感興趣的文章!
本文作者可以追加內容哦 !
鄭重聲明:本文版權歸原作者所有,轉載文章僅為傳播信息之目的,不構成任何投資建議,如有侵權行為,請第一時間聯絡我們修改或刪除,多謝。
標題:MOSFET與IGBT的區別
地址:https://www.breakthing.com/post/51612.html







