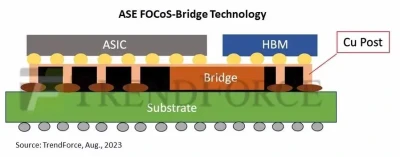
爲了滿足高性能運算、AI、5G等應用需求,高端芯片走向小芯片設計、搭載HBM內存已是必然,因此封裝形態也由2D邁向2.5D、3D。隨着芯片制造持續往更小的制程節點邁進,晶圓代工廠利用先進封裝技術直接封裝芯片的模式應運而生。
不過,此模式也意味着晶圓代工廠將攫取傳統封測廠的部分業務,所以自從台積電於2011年宣布進軍先進封裝領域之後,其對於傳統封測廠的“威脅論”就不曾間斷,只是此說法是否屬實呢?
事實上,傳統封測廠仍具備一定的競爭力,首先是大量電子產品仍仰賴其多元的傳統封裝技術。特別是近年來,在 AIoT、電動汽車、無人機高速發展下,其所需的電子元件仍多半採用傳統封裝技術。其次,面對晶圓代工廠積極切入先進封裝領域,傳統封測廠也未有怠慢,紛紛提出具體解決方案。
傳統封測廠的先進封裝
2023年以來,AIGC迅速發展,帶動AI芯片與AI服務器熱潮,而由台積電推出、被稱爲CoWoS的2.5D先進封裝技術更是扮演關鍵角色。然而,突如其來的需求讓台積電應接不暇,面對此情況,傳統封測大廠如日月光、Amkor也相繼展現技術實力,並未打算在此領域缺席。
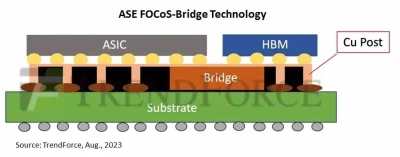
日月光FOCoS-Bridge結構圖
例如,日月光的 FOCoS 技術能整合 HBM 與核心運算組件,將多個芯片重組爲扇出模塊,再置於基板上,實現多芯片的整合。其在今年五月份發布的FOCoS-Bridge技術,則能夠利用硅橋(Si Bridge)來完成2.5D封裝,助力打造AI、數據中心、服務器應用所需的高端芯片。
此外,日月光旗下硅品的FO-EB技術,亦是整合核心運算組件與HBM的利器,從下圖來看,該技術不使用硅中間層,而是透過硅橋與重分布層(RDL)實現連結,同樣能夠實現2.5D封裝。
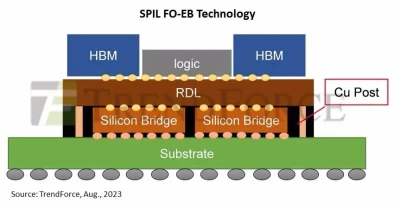
硅品FO-EB結構圖
而另一家封測大廠Amkor除了與三星共同开發H-Cube先進封裝解決方案以外,也早已布局「類CoWoS技術」,其透過中間層與TSV技術能連接不同芯片,同樣具備2.5D先進封裝能力。
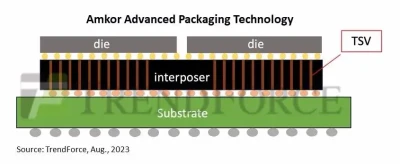
Amkor技術結構圖
中國大陸封測廠商江蘇長電的XDFOI技術,則是利用TSV、RDL、微凸塊技術來整合邏輯IC與HBM,面向高性能計算領域。
近來高端GPU芯片需求驟升,台積電CoWoS產能供不應求,NVIDIA也積極尋求第二甚至第三供貨商的支援,日月光集團已然憑借其2.5D封裝技術參與其中,而Amkor的類CoWoS技術也磨刀霍霍,足以說明傳統封測大廠即便面對晶圓代工廠切入先進封裝領域的威脅,仍有實力一战。
再就產品別來看,晶圓廠先進封裝技術鎖定一线大廠如英偉達、AMD; 而其他非最高端的產品,仍會選擇日月光、Amkor、江蘇長電等傳統封測廠進行代工。整體來看,在不缺席先進封裝領域,並且掌握逐步擴張之既有封裝市場的情況下,傳統封測大廠依舊能保有其市場競爭力。
本文作者可以追加內容哦 !
鄭重聲明:本文版權歸原作者所有,轉載文章僅為傳播信息之目的,不構成任何投資建議,如有侵權行為,請第一時間聯絡我們修改或刪除,多謝。
標題:晶圓代工龍頭與封測大廠角逐先進封裝!
地址:https://www.breakthing.com/post/91179.html







